Sn-Pb钎料因其熔点低、成本低廉和润湿性良好等优点被广泛应用于电子封装,但因为Pb的毒性而逐渐被剔出电子工业,取而代之的是无铅钎料。据研究表明,Sn基材料仍然是取代传统锡铅焊料的最佳选择,在Sn中添加Ag、Zn、Cu、Bi、Sb、In等第二组元,并通过少量添加稀有元素来不断调节焊料的可焊性,进一步优化其熔点及物理性能。下面介绍一下LED封装焊接中经常应用的无铅钎料。
1)Au-Sn钎料
Au80Sn20焊料作为一种无铅焊料,具有良好的润湿性和流动性,而且适用于无钎剂钎焊,可避免对元器件的污染。Au-Sn焊料的接头强度大、热导率高、耐腐蚀,是一种广泛应用于微电子器件、光电子器件封装的高可靠性钎料。
Au80Sn20合金焊料为共晶成分:80%Au和20%Sn(质量分数),共晶温度为280℃。根据Au-Sn相图(见图6-23),温度高于280℃时,Au-Sn焊料迅速熔化。随着温度下降至280℃发生共晶反应:L→δ-AuSn+ζ,形成δ-AuSn相和不稳定的ζ相,ζ相的Sn含量为9.1%~17.6%(原子分数)。温度继续下降至190℃时,发生包析反应:ζ+δ→ζ′-Au5Sn。室温下Au80Sn20钎料由δ-AuSn和ζ′-Au5Sn两种脆性相组成。应该指出的是,固态下的金锡合金均没有出现单质的锡或者金,而是以不同的金锡金属间化合物的混合组织出现,因此原则上讲金锡合金的化学性质与纯金类似,非常稳定,不易被氧化和腐蚀。但是,金与锡形成的金属间化合物(IMC)都是脆相,所以固态下的金锡合金都具有极大的脆性,较难用常规方法加工成型。其基本物理性质见表6-4。
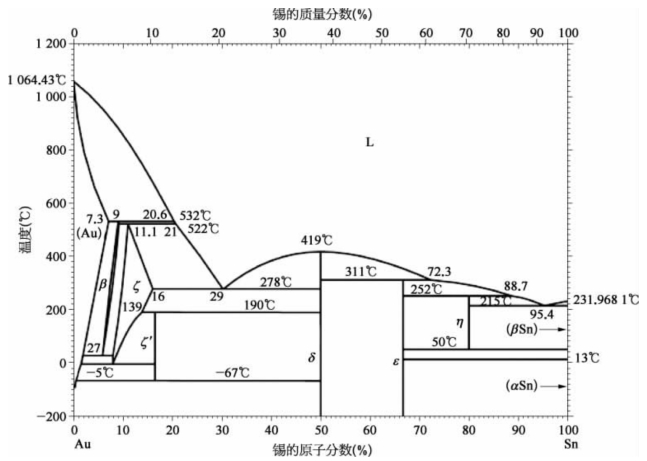
图6-23 Au-Sn相图
表6-4 Au80-Sn20焊料在20℃时的物理性质

(续表)

AuSn20的熔点是280℃,非常适合作为电子焊接材料。作为共晶合金,AuSn20有着细小均匀的晶格、很高的强度的特征(焊接强度为47.5 MPa),因而能够耐受热冲击、热疲劳,能够在高温环境或者温度变化幅度大的环境下使用。AuSn20具有良好的漫流性,能够很迅速地铺展开来,保证焊接的密封性。AuSn20的热导率为57 W/(m·K),是所有钎焊料中最高的。AuSn20的抗蚀能力与抗氧化能力较强。AuSn20焊料可直接在镀金层上焊接(“不吃金”)。
但是金锡共晶合金焊料也有不少缺点。首先金锡合金焊料的金含量很多,制作成本相对于锡铅焊料增加了不少;其次,由于其成分为包含两种IMC的共晶组织,脆性很大,很难对其进行成型、冲裁等机械加工。
2)Sn-Ag-Cu(Sn96.5Ag3.0Cu0.5)钎料
Sn-Ag-Cu(SAC)焊料是最常用的无铅焊料。目前,认可度最高的是日本JEITA推荐使用的SAC305(Sn-3.0Ag-0.5Cu)合金。
图6-24为Sn-Ag-Cu合金的三元相图。从图中可以观察到Sn-Ag-Cu合金的共晶组织有β-Sn、Ag3Sn和Cu6Sn5,液相线的温度区间为217~227℃。该相系具有以下主要特点:熔化温度接近Sn-Pb共晶温度;有较好的润湿性能和钎焊工艺性能;有较好的物理性能,如强度、抗蠕变和热疲劳性能,金属组织稳定性强;有较好的化学性能,使钎焊接头有良好的耐腐蚀性;良好的导电性和导热性能。
 (https://www.daowen.com)
(https://www.daowen.com)
图6-24 Sn-Ag-Cu三元相图
直到目前,Sn-Ag-Cu的共晶成分还没有被准确地确定下来,熔化温度范围大,熔点过高是Sn-Ag-Cu最大缺陷。另一方面,Ag作为贵重金属提高了SAC焊料的成本,成本的提高也是限制SAC使用的重要因素。
3)其他无铅钎料
无铅钎料按其合金元素分为Sn-Zn系、Sn-Cu系、Sn-Ag系、Sn-Ag-Cu系、Sn-Bi系、Sn-In系等系列无铅钎料。其中研究最广泛的是Sn-Ag-Cu(SAC)、Sn-Zn、Sn-Ag和Sn-Cu无铅钎料。它们的优缺点见表6-5。
表6-5 常见无铅钎料性能

4)钎料性能的改进
(1)浸润性能
润湿性是指一种液态金属在一种固体表面铺展的能力。评定钎料润湿性的常用指标有:铺展面积、润湿时间和润湿力。一般而言,拥有良好润湿性的钎料应具有较高的润湿力和较短的润湿时间。
钎焊过程中镀层金属溶解到熔融钎料中,二者之间的互溶度是影响润湿性的关键。
温度直接影响Au在Au-Sn中的浸润性。390℃时,Au-Sn焊球表现出最好的润湿性,润湿角为25°,润湿动力学取决于熔融Au-Sn焊球表面的氧化和Au的溶解速率。300~390℃时,润湿性主要取决于Au的溶解速率,随着温度升高而增加。390℃以上时,Au-Sn焊料表面的氧化速率超过Au的溶解速率,润湿性逐渐下降。440℃出现不润湿现象。
对于Sn-Ag-Cu钎料,添加适量的Bi、In、Zn、Al、Ni、Ge、Sb、Fe、稀土元素Er、Re、重金属元素Y、Ce、纳米Al2O3、TiO2、微量Ni涂层碳纳米管等,能够有效地提高润湿性,而添加Ga、Mg、纳米Co颗粒、Al、Ni却会降低润湿性。
(2)界面反应
焊料与镀层之间的结合主要通过发生界面反应形成Au-Sn、Ni-Sn金属间化合物来实现。Cu、Pt的原子结构与Au相似,以置换原子的形式溶解在金属间化合物中。镀层结构、焊盘尺寸、回流次数、时效时间和时效温度等与金属间化合物的形成和老化有关,是电子封装中工艺流程及结构设计、使用寿命评估需要考虑的重要因素。
(3)加热方法
对于钎料合金作为TIMs的芯片键合主要有再流焊、热板加热、活性自反应钎焊、感应局部加热等方法。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。








