LED封装结构可根据应用产品的需求而改变。根据不同的应用需要,LED的芯片可通过多种封装方式做成不同结构和外观的封装器件。按LED显示屏用器件的封装形式,主要分为直插式封装(Dual In-line Package,DIP)、点阵封装和表面贴装封装(SMD LED);按LED照明用器件的封装形式,主要分为SMD LED、功率型封装(High Power LED)、板上芯片封装(COB)、倒装封装(Flip Chip)、芯片级封装(Chip Scale Package,CSP)和系统级封装(System In a Package,SIP)等类型。
1)直插式封装(DIP)
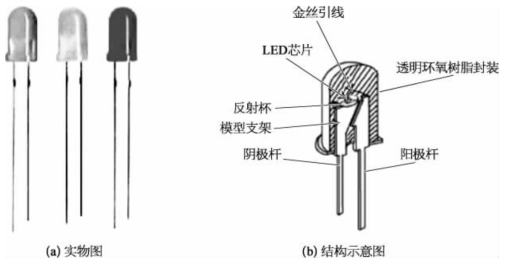
图5-1 直插引脚式封装
LED芯片的直插引脚式是最先研发成功并投放市场的LED产品,技术成熟,品种繁多。图5-1为直插引脚式封装,通常支架的一端有碗杯形结构,将LED芯片固定在碗杯形结构内,然后采用灌封封装。灌封是先在LED模腔内注入液态环氧树脂,然后插入压焊好的引脚式LED支架并放到烘箱中让环氧树脂固化,再从模腔中脱离出LED即成型,成为LED产品[37]。由于芯片产生的热量主要通过引线传导,散热量比较小,热阻较大(一般高于100℃/W),因此LED直插式封装适用于小功率芯片。
2)表面贴装封装(SMD)
表面贴装封装是将单个或多个LED芯片粘焊在带有塑胶杯形外框的金属支架上,再往塑胶外框内灌封液态封装胶,然后高温烘烤成型,最后切割分离成单个表贴封装器件(见图5-2)。与引脚式封装技术相比,SMD LED的亮度、一致性、可靠性、视角、外观等方面表现都良好。SMD LED体积更小,重量更轻,且适合回流焊接,自动化程度较高,便于批量生产。但是在应用中SMD LED存在散热、发光均匀性和发光效率下降等问题。
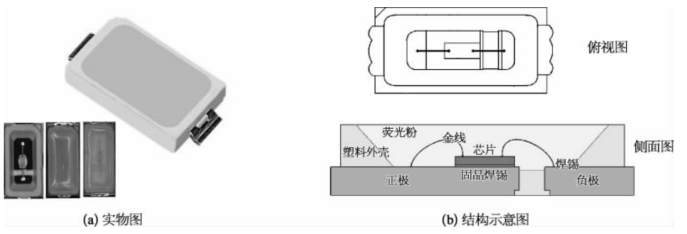
图5-2 SMD LED(3014)
3)功率型LED(HP LED)封装
随着LED照明应用领域的不断扩大,人们不断追求大功率、高光效的LED照明需求,同时对LED的封装体积、结构紧凑性要求越来越严格,逐渐提出功率型LED封装。功率型LED分为功率LED和W级功率LED。功率LED一般指功率大于0.3 W而小于1 W的LED,而W级功率LED指功率大于1 W的LED。功率型封装有两种方式:单颗封装和集成封装。封装基板一般是陶瓷基板或者是金属基板。Lumileds公司的LUXEON系统,Osram公司的Golden Dragon是具有代表性的第一代功率LED。近年来,Cree、Nichia、亿光、首尔半导体、木林森等都研发了具有特色的功率型LED(见图5-3)。
大功率LED有大的耗散功率、大的发热量,并且期望其有更高的出光效率、更长的寿命,因此在封装结构设计、选用材料及选用设备等方面必须精心考虑。其中,关键技术包括荧光粉涂覆工艺、取光技术及晶电防护方法等,尤其重要的是散热技术,包括散热基板、共晶技术及工艺、封装结构等,是提高大功率LED性能和延长使用寿命的保证。
4)板上芯片封装(COB)
COB封装是指将LED芯片直接固定在印刷线路板(PCB)上,芯片与线路板间通过引线键合进行电气连接的LED封装技术(见图5-4)。其可以在一个很小的区域内封装几十甚至上百个芯片,最后形成面光源。与点光源封装相比,COB面光源封装技术具有价格低廉(仅为同芯片的1/3左右)、节约空间、散热容易、发光效率提高、封装工艺技术成熟等优点[39]。

图5-3 功率型LED

图5-4 COB LED
COB集成式封装相对于单颗分立式封装具有更好的散热性能,主要是由于COB封装是芯片直接将热量传导到基板上,再通过基板传导到外壳;而大功率COB封装中,多个大功率芯片近距离地集成在一起,散热问题还是要首先解决的问题。COB散热涉及芯片、基板、共晶技术、封装胶及封装结构设计,只有综合考虑各因素及它们之间的耦合关系,才能够有效地提高COB的散热效果。
5)倒装封装(FC)
相对于正装结构LED芯片,倒装结构LED芯片封装的方式称为倒装封装,其特点是用覆晶焊技术将倒装芯片的金凸点直接焊接在支架上形成电极和散热通道。由于没有金线,提高了产品的可靠性和成品率,减小了封装体积,可实现多芯片集成。同时热阻低,散热性能好,封装工艺简化,降低了封装成本,提高了生产良率,非常适合于中大功率LED应用。
从图5-5倒装封装LED结构示意图可知,倒装LED封装结构可以将芯片的热量直接通过共晶键合层传导到LED支架,降低了封装器件的热阻,增强了封装LED器件的散热性能。通过已有的分析可知,共晶层、金凸点形态、底部沟槽填充、支架结构及材质等,都会影响倒装LED封装的散热效果。(https://www.daowen.com)
6)芯片级封装(CSP)
CSP封装是基于倒装技术而发展起来的,是指将封装体积与倒装芯片体积控制至相同或封装体积不大于倒装芯片体积的20%。此类LED封装可以将部分封装工序提前到芯片工艺阶段完成,后续可以直接将倒装芯片封焊到封装基板线路的焊盘上,无金线、无支架,生产流程简化,降低生产成本,封装尺寸可以做得更小(最薄可以达到30μm),并且同样的封装尺寸可以提供更大的功率和更好的散热性能(见图5-6)。业内对于CSP封装的定义还存在不同的解释和看法,如“免封装”、无基板的近芯片级封装(NCSP),以及电路板上的晶圆级集成芯片(WICOP)等。近年来随着LED倒装芯片的快速发展,CSP LED芯片也得到半导体照明行业的广泛关注,并得到实际应用。
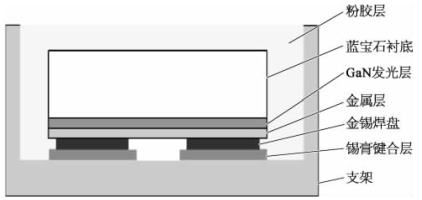
图5-5 倒装封装LED结构示意图[40]
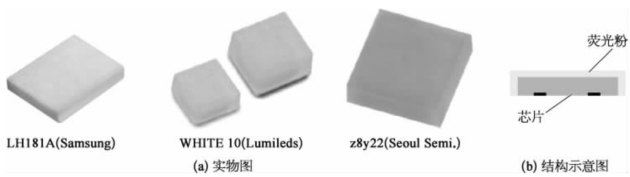
图5-6 CSP LED
7)系统级封装(SIP)
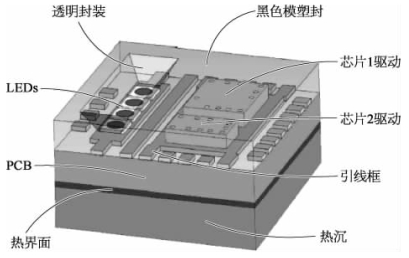
图5-7 SIP LED结构示意图[41]
SIP是近几年来为适应整机的便携式发展和系统小型化的要求,在系统芯片基础上发展起来的一种新型封装集成方式。对SIP LED而言,不仅可以在一个封装内组装多个发光芯片,还可以将各种不同类型的器件(如电源、控制电路、光学微结构、传感器等)集成在一起,构建成一个更为复杂的、完整的系统。SIP具有工艺兼容性好、集成度高、成本低、可提供更多新功能、易于分块测试、开发周期短等优点。按照技术类型不同,SIP可分为四种:芯片层叠型、模组型、MCM型和三维(3D)封装型。
目前,高亮度LED器件要代替白炽灯以及高压汞灯,必须提高总的光通量,或者说可以利用的光通量。而光通量的增加可以通过提高集成度、加大电流密度、使用大尺寸芯片等措施来实现。由于发光芯片的高密度集成,散热基板上的温度很高,必须采用有效的热沉结构和合适的封装工艺。
8)交流LED(Alternating Current LED,AC LED)封装
AC LED是一类集成了各种处理技术的LED产品,它包括多种器件或内核,无须额外的变压器、整流器和驱动电路,交流电直接对其进行驱动。AC LED通过半导体制程技术整合成一堆微小晶粒,采用交错的矩阵式排列工艺,并加入桥式电路至芯片设计,使交流电流可双向导通,通过LED的轮替点亮及余晖续光的特性实现“连续”发光。
AC LED包括两种基本结构。一种是基于惠斯通电桥,将一堆LED微小晶粒采用交错的矩阵式排列工艺均分为五串,晶粒串组成了一个整流桥,整流桥的两端分别连接交流源,另两端连接一串LED晶粒,交流的正半周沿实线通路流动,3串LED晶粒发光,负半周沿虚线通路流动,又有3串LED晶粒发光,四个桥臂上的LED晶粒分两组轮流发光,中间一串晶粒因共用而一直发光(见图5-8a)。另一种是采用交错矩阵式排列工艺均分为正反方向的两串,在交流电正负半周内分别点亮一次LED微小晶粒从而实现交流驱动LED,此结构中两串LED发光的时间相等,解决了全桥式排列中工作时间不均而造成使用寿命长短不一的缺点(见图5-8b)[42]。
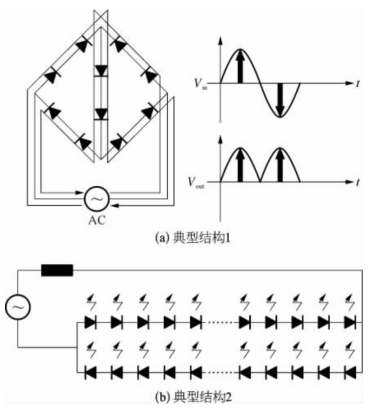
图5-8 AC LED典型结构
LED有一半时间在工作,有一半时间在休息,因而发热得以减少20%~40%。因此,AC LED的使用寿命较DC LED长。但芯片瞬态结温会随着交变电流的频率而波动,交变电流的频率越低,瞬态结温的波动越大,此时热阻概念不能再适用。在粗略估算下,可以用平均结温来表示结温,此时可以用热阻概念及相关公式大致估算结温及相关量。
9)高压LED(High Voltage LED,HV LED)封装
传统大功率LED需低电压、大电流驱动,导致器件出现严重的热耗,光出射效率低,Droop效应严重,电流扩展差。为了解决大电流驱动带来的问题,人们提出了高压LED的概念。简单而言,高压LED就是把一个芯片的外延层分割成数个独立的芯粒单元,并通过电极互连而构成的新型LED芯片(见图5-9)。理论上和单个LED灯珠串联起来形成大功率LED类似,但是高压LED在芯片进行刻蚀隔离,体积更小,可靠性更高。
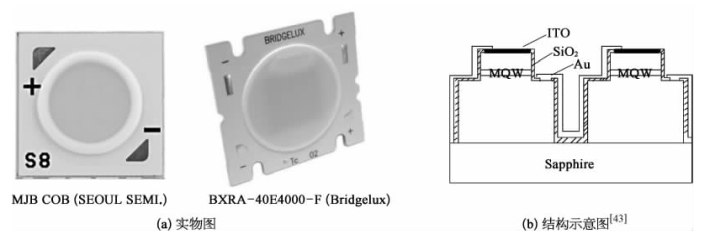
图5-9 HV LED
由于使用的是低电流驱动,高压LED器件具有更高的可靠性,同时又简化了匹配电源,可使用具有更少电子元器件的驱动电源,减小了电源中元器件之间能量转换的损失。在相同功率条件下,高压直流LED所用的驱动电流远小于传统大功率LED器件,大大减小了AC→DC转换效率的损失。采用直流高压LED还可以大幅降低对散热外壳和散热系统的设计要求,意味着整体LED的成本降低了许多。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。






