1)提高内量子效率的方法
①采用极化匹配的多元组分材料来替代GaN作为势垒层,可以有效改善QCSE效应,提高LED的发光效率。可以利用Al0.05Ga0.95N、四元Al0.05In0.05Ga0.9N材料作为多量子阱区的势垒层;也可以采用阶梯状的p型掺杂GaN来作为势垒层;还可以设计GaNIn0.05Ga0.95N-GaN结构和InGaN-AlGaN-InGaN结构来替代传统的GaN势垒层[26]。
②调整势阱层的结构也可以提高LED的发光效率。传统的GaN MQWs LED势阱层In组分是保持不变的,由于极化电场的存在,电子和空穴的波函数在空间上发生分离。通过调节势阱层的In组分,来增加电子和空穴的波函数重叠的概率,提高LED的发光性能。例如,采用In0.2Ga0.8N/In0.26Ga0.74N两层阶梯状的势阱层结构,In组分呈梯形状渐变的势阱层结构,In组分呈三角形状渐变的势阱层结构,类似三明治的In0.21Ga0.79N/In0.28Ga0.72N/In0.21Ga0.79N交错形势阱层结构等[26]。
③电子阻挡层(EBL)也对GaN基LED的发光效率具有重要的影响。早期研究者在MQWs与p型GaN之间插入p-AlGaN作为EBL,宽禁带的EBL可以引入较大的电子势垒,有效抑制电子泄露出有源区。但近年来Han等人研究发现,在小电流下EBL结构的确可以增强LED的发光效率,但当电流增大以后,由于对空穴注入的阻挡效应增强,空穴的注入效率减小,EBL反而会降低LED的发光效率。在大电流下,相比Al0.2Ga0.8N,In0.18Al0.82N更适合做LED的EBL。同时,在不改变EBL材料的前提下,通过改变AlGaN的Al组分来提高LED的发光效率[26]。
④俄歇复合、去局域化、电子泄露严重、有源区辐射复合效率低是造成效率骤降的原因,其中空穴注入浓度不足,是造成骤降原因中较为重要的原因,提高GaN材料的p型掺杂浓度,是实现大功率高光效白光LED的重要课题[27]。
2)提高出光效率的方法
在LED器件中,发光的有源层半导体材料折射率大于外部介质材料的折射率,因而当被激发光子的射出角度大于全反射角时,将无法逸出LED器件,并最终转化为热,使得LED提取效率无法提高,直接影响了LED发光效率及寿命。常用提高出光效率的方法主要有以下几种:
(1)芯片异形技术
大多数实用的LED是用平面技术并用矩形结构制备的。平面矩形LED的量子效率大多不高。这就需要考虑采用非矩形芯片,如抛物线形、半球形、截球形、三角形、平行四边形、倒金字塔形等(见图4-3)。
LED芯片异形可以使内部反射的光从侧壁的内表面再次传播到上表面,而以小于临界角的角度出射,同时使传播到上表面大于临界角的光重新从侧面出射,这两种过程能同时减小光在内部传播的路程[28]。
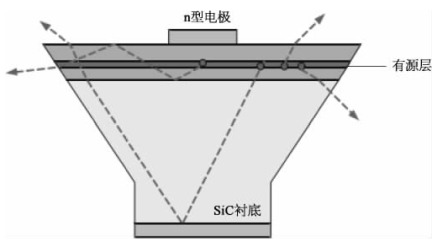
图4-3 衬底倒金字塔设计提高出光效率示意图
(2)生长分布布拉格反射层(DBR)结构与光子晶体
DBR结构是两种折射率不同的材料周期交叠生长的层状结构(以ABAB…的方式交替排列组成,每层的厚度都是操作波长的四分之一,相当于简单的一维光子晶体),它在有源层和衬底之间,能够将射向衬底的光反射回表面或侧面,减少衬底对光的吸收,提高发光效率,而且两种材料折射率相差越大,DBR结构的反射率也越大。
现在采用不同中心波长复合结构的DBR配合其他优化结构,光取出效率的改善效果会更加明显,而且DBR结构可通过直接MOCVD外延完成,具有很好的成本优势,材料晶格常数与衬底匹配,反射率高,对器件的电学特性影响小。
光子晶体(Photonic Crystal,PC)指不同介电常数材料的周期性排列,在空间周期与光波波长相当时,由于周期性的布拉格散射形成光子禁带,能够抑制LED出射光子的横向传输,获取更高的抽光效率。
目前,主要用二维光子晶体来提高LED的出光效率,其影响出光效率的主要因素有光子晶体的结构、晶格常数和高度等。光子晶体结构就是光栅。进入导光模的光和周期与光波长相当的光栅结构发生作用时,光波矢平面内的分量会受到调制,从而使导光模的光落在出射光锥内,被耦合为出射光,这就是光栅衍射效应,是目前光子晶体在LED照明领域的主要应用。光子晶体可以位于P-GaN表层、N-GaN层中,以及N-GaN表层。
(3)表面粗化技术
粗化技术(Roughening)主要是指使用干法或者湿法微加工工艺在P-GaN层、非掺杂GaN或ITO膜上制作随机的图形结构,这些随机的粗化结构能够增加材料与空气的接触面积,使光在出射面上发生更多的折射、反射,增加光子的出射概率,有利于光提取效率的提高[29]。
图形化蓝宝石衬底(Patterned Sapphire Substrate,PSS)技术,就是在蓝宝石衬底上利用湿法刻蚀或干法刻蚀形成图形,再在其上生长GaN材料,使GaN材料的纵向外延变为横向外延。这种生长方式使GaN层内位错密度量可降低1个数量级左右。一方面可以有效减少GaN外延材料的位错密度,从而减小有源区的非辐射复合,减小反向漏电流,提高LED的寿命;另一方面有源区发出的光经GaN和蓝宝石衬底界面多次散射,改变了全反射光的出射角,增加了倒装LED的光从蓝宝石衬底出射的概率,从而提高了光的提取效率(见图4-4)。综合这两方面的原因,使PSS上生长的LED的出射光亮度比传统的LED大大提高,同时反向漏电流减小,LED的寿命也得到了延长。
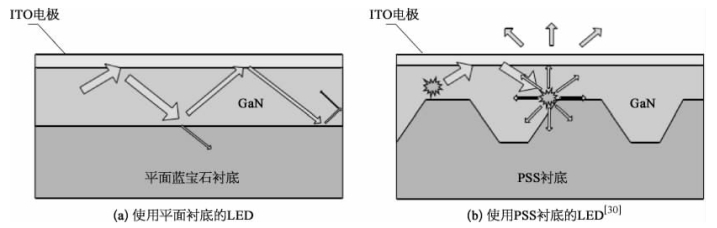
图4-4 两种LED内部光路对比
3)不同的衬底对发光效率的影响
衬底又称封装基板。衬底主要是外延层生长的基板,在生产和制作过程中起到支撑和固定的作用。它与外延层的特性配合要求比较严格,否则会影响到外延层的生长,进而影响芯片的品质。对于制作LED芯片来说,衬底材料的选用是首要考虑的问题。衬底的热导率及厚度直接决定着芯片的热阻(见图4-1)。因此,选择与GaN晶格失配与热失配都较小,且具有较好的导热性能的衬底材料,是提高IQE和改善芯片热性能的主要手段。
常用的LED衬底包括蓝宝石、SiC、Si、ZnO、LiAlO2等,它们的基本性质见表4-3。
表4-3 几种LED衬底的主要性能对比(GaN为外延层)

(续表)
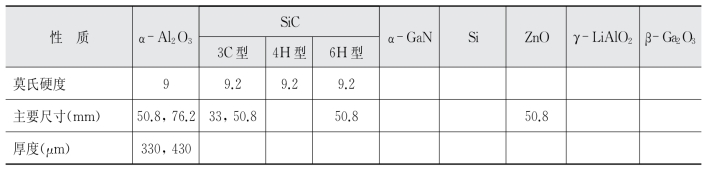
(1)蓝宝石(Sapphire,α-Al2O3)
蓝宝石(α-Al2O3)是目前主流衬底材料。GaN基器件大多在蓝宝石衬底的C面上生长。但C面蓝宝石衬底上生长的GaN薄膜是有极性的,主要有自发极化和压电极化。一般在薄膜中形成很强的极化场(达MV/cm量级),极化场将阻止发光器件中载流子的注入,由极化场引起的QCSE效应将使发光器件的辐射复合效率降低和发光峰红移,因此随着注入电流的增加,发光峰将出现显著的红移,这些发光波长的不稳定性和发光效率低是C面蓝宝石衬底上生长的GaN极性薄膜所不可避免的,这大大限制了GaN基光电器件的大功率化,尤其是在GaN基白光照明革命上形成了很大的障碍。

图4-5 蓝宝石晶面示意图
而在一些非C面蓝宝石衬底(如R面或M面)(见图4-5)生长的GaN薄膜是非极性和半极性的,上述由极化场引起的在发光器件中产生的负面效应将得到部分甚至完全的改善。现今研究的非极性或半极性GaN主要包括R面蓝宝石上的非极性A面GaN,M面蓝宝石上的半极性(1013)或(1122)面GaN。常规外延获得的非极性或半极性GaN存在表面粗糙、缺陷多和不稳定等缺点,因此要改善这些必须采用侧向外延、氢化物气相外延(HVPE)技术和优化外延生长参数等[31]。
(2)碳化硅(SiC)
碳化硅属于Ⅳ-Ⅳ族半导体材料,是目前市场占有率仅次于蓝宝石的LED衬底材料。SiC具有多种晶型,可分为三大类:立方形(如3C-SiC)、六角形(如4H-SiC)和菱形(如15R-SiC),绝大部分晶体为3C、4H和6H三种晶型,其中4H-SiC、6H-SiC主要用作GaN衬底。
在常见的异质外延衬底中,碳化硅具有最低的晶格失配与热失配,最适合生长高质量GaN外延层。同时,SiC良好的导电性和热导性有利于制备垂直结构的高功率器件,可以比较好地解决功率型氮化镓LED器件的散热问题。美国Cree公司使用SiC衬底制造的LED,光效为276 lm/W[30]。
SiC作为衬底也有许多不足之处。SiC本身的热膨胀系数又比GaN低,在冷却的过程中一样会有双轴应力的产生,所以也需要低温的氮化铝缓冲层来提升GaN的质量。在GaN外延生长前的处理过程中很难得到粗糙度低的SiC表面。另外,价格太高、晶体质量难以达到Al2O3和Si那么好、机械加工性能比较差,同时由于其层状结构,在衬底的表面常会给外延膜引入大量缺陷。另外,SiC衬底吸收380 nm以下的紫外光,不适合用来研发380 nm以下的紫外LED[32]。
(3)单晶硅(Si)
硅材料是目前应用最广泛、制备技术最成熟的半导体材料。由于单晶硅材料生长技术成熟度高,容易获得低成本、大尺寸、高质量的衬底,可以大大降低LED的造价。并且由于硅单晶已经大规模应用于微电子领域,使用单晶硅衬底有望实现LED芯片与集成电路的直接集成,有利于LED器件的小型化发展。因此,使用单晶硅作为LED衬底一直是本行业梦寐以求的事情[30]。
与目前应用最广泛的LED衬底——蓝宝石相比,单晶硅在性能上还有一些优势:热导率高,导电性好,可制备垂直结构,更适合大功率LED制备[30]。
然而与蓝宝石和SiC相比,在Si衬底上生长GaN更为困难,主要体现在以下方面[33]:
①二者之间的热失配和晶格失配更大(见表4-3)。
②Si与GaN的热膨胀系数差别也将导致GaN膜出现龟裂。
③晶格常数差会在GaN外延层中造成高的位错密度。
④Si衬底LED还可能因为Si与GaN之间有0.5 V的异质势垒而使开启电压升高,以及晶体完整性差造成p型掺杂效率低,导致串联电阻增大。
⑤Si吸收可见光会降低LED的外量子效率。
(4)氧化锌(ZnO)
ZnO作为GaN外延片的候选衬底,主要是因为二者具有非常惊人的相似之处。二者晶体结构相同,晶格失配度非常小,禁带宽度接近(能带不连续值小,接触势垒小)。ZnO本身是一种有潜力的发光材料。ZnO的禁带宽度为3.37 eV,属直接带隙,和GaN、SiC、金刚石等宽禁带半导体材料相比,它在380 nm附近紫光波段发展潜力最大,是高效紫光发光器件、低阈值紫光半导体激光器的候选材料。ZnO材料的生长非常安全,可以采用没有任何毒性的水为氧源,用有机金属锌为锌源[33]。
但是,ZnO作为GaN外延衬底的致命的弱点是在GaN外延生长的温度和气氛中容易分解和被腐蚀。目前,ZnO半导体材料尚不能用来制造光电子器件或高温电子器件,主要是材料品质达不到器件水准和p型掺杂问题没有真正解决,适合ZnO基半导体材料生长的设备尚未研制成功。今后研发的重点是寻找合适的生长方法。(https://www.daowen.com)
(5)氮化镓(GaN)
GaN自然是最适合用来作为GaN外延膜生长的衬底材料。同质外延生长从根本上解决了使用异质衬底材料所遇到的晶格失配与热失配问题,将生长过程中由于材料之间性质差异所引起的应力降到最低,能够生长出异质衬底无法相比的高质量GaN外延层。GaN衬底最突出的优势在于适合高质量外延层生长与低骤降效应的高功率、高光效器件。使用GaN衬底无须缓冲层,可实现最简单的LED结构,外延生长的成本大大降低。
然而,GaN单晶的生长成本较高、尺寸较小,将对其应用造成障碍。GaN体单晶制备技术的研发是重要发展方向[30]。
(6)铝酸锂(LiAlO2)
LiAlO2是一种最具发展前景的衬底材料,正方晶系γ-LiAlO2与GaN的结构比较接近,它们之间的晶格不匹配数仅为1.4%。因此常用来生产非极性外延片,如(100)面γ-LiAlO2上的非极性M面GaN。因为γ-LiAlO2拥有低的热膨胀系数,所以在外延薄膜生长的过程中不需要缓冲层消除应力来降低差排密度。又因(100)面比较容易研磨、抛光,而且γ-LiAlO2会被水慢慢地腐蚀,所以在抛光的过程中可以利用水作为抛光液,可以降低衬底材料的制备成本[31]。
(7)氧化镓(Ga2O3)
β-Ga2O3属于单斜晶系,与GaN的晶格失配仅为8.5%,是近年来发展起来的新型GaN衬底材料。作为透明导电氧化物的一种,β-Ga2O3在可见光波段透过率>80%,且具有高的禁带宽度(4.8 eV),可透过波长最短为260 nm的紫外光,从可见光LED对衬底材料的应用要求来看,其透光性可与蓝宝石相当。β-Ga2O3为n型半导体,具有一定的导电性能,可通过掺杂改变其导电性,具有类似SiC的特性。β-Ga2O3具备蓝宝石的透光性与碳化硅的导电性,且可使用熔体法实现大尺寸生长,因此可被视为是一种可替代蓝宝石和SiC的理想GaN衬底材料。
总之,单晶硅、碳化硅、氮化镓在热导率与导电性方面均优于蓝宝石。然而由于存在巨大的晶格失配与热失配,外延生长过程复杂,生产工艺仍需提高。碳化硅、氮化镓总体性能均优于蓝宝石,适合高光效、大功率器件上的应用,然而目前衬底本身的制备技术限制了应用。铝酸锂作为重要的非极性衬底,可以生产制备非极性外延片。氧化镓作为新型透明导电衬底,可制备垂直倒装结构LED,适合应用于大功率器件。
4)垂直和倒装芯片
(1)倒装芯片(Flip Chip,FC)
针对传统正装LED存在的散热差、透明电极电流分布不均匀、表面电极焊盘和引线挡光以及金线导致的可靠性问题。1998年,J.J.Wierer等人制备出了1 W倒装焊接结构的大功率AlGaInN-LED蓝光芯片,他们将金属化凸点的AlGaInN芯片倒装焊接在具有防静电保护二极管(ESD)的硅载体上。传统的正装芯片通过金属线键合与基板连接的晶片电气面朝上,而倒装晶片的电气面朝下,相当于将前者翻转过来,故称其为“倒装芯片”。
倒装焊芯片通过倒装焊技术,将LED芯片的光传输通道和热传输通道分离,芯片产生的光从紫外透过率高的蓝宝石衬底出射,芯片有源层产生的热量则在另一侧通过焊接层传导至热导率较高的硅衬底,再经硅衬底传导至金属基板,从而有效地降低了芯片热阻,提高了散热能力,并增大了出光效率。
相对于正装结构,倒装焊芯片的结构较为复杂,其热学特性受到众多因素的影响。有实验表明,凸点(焊点)结构、凸点缺陷、硅衬底结构等对芯片温度分布有很大影响。倒装焊芯片由于采用倒装技术,在散热通道中增加了凸点、黏结层、散热基底等一系列功能结构与节点,同时蓝宝石衬底在芯片散热通道的位置与作用也与正装芯片有较大差异。根据4.1.1节的分析,倒装GaN的热通道各环节的尺寸、热导率及热阻见表4-4。
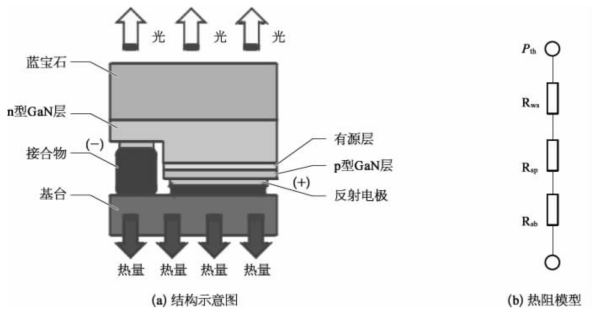
图4-6 倒装LED芯片结构示意图及热阻模型
表4-4 典型1W GaN基倒装芯片各层尺寸、热导率及热阻
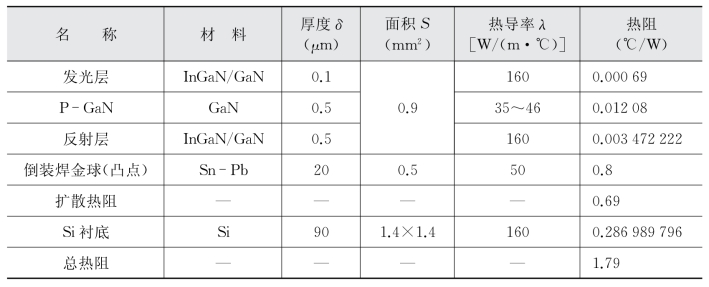
由此可见,LED倒装芯片的热阻主要决定于凸点热阻Rws、扩散热阻Rsp和Si衬底的热阻Rsb(见图4-6b),总热阻比正装芯片的热阻略低一些。
虽然和正装LED芯片热阻略低,但是倒装芯片热阻并没有特别突出的散热优势,主要原因如下:
①芯片与Si衬底之间焊接层的影响。由于目前所用焊接材料——铅锡焊料的热导率只有约50 W/(m·K)(若使用金凸点,此环节热阻降低为0.13℃/W),并不比蓝宝石高很多,同时焊接层的整体面积小于蓝宝石层。此外,如果由于焊接质量不高,使得金属化层和Si衬底之间存在虚焊,这些都增大了倒装焊LED器件的热阻。
②衬底材料和工艺的影响。在倒装焊LED芯片中,用得较多的是Si材料,其优点是工艺成熟。但Si的机械强度不高,使其厚度无法进一步减小,同时Si的导热性能也不是很强,这也制约了倒装焊芯片性能的提高。
③由于凸点面积比Si衬底面积小,热量流经凸点传递到Si衬底的过程中,存在着扩散热阻(0.69℃/W),通过理论计算这个热阻对倒装芯片的整个热阻有很大的影响,若设计不合理,倒装芯片的总热阻将高于正装芯片总热阻。
因此,如果不能有效地解决焊接层的热导率、焊接质量和优化工艺参数等问题,不但不能够体现倒装焊技术在散热方面的优势,甚至还会比正装芯片更差[34]。
为了进一步提高倒装芯片的光效,2006年O.B.Shchekin等人又研制了一种新的薄膜倒装焊接的多量子阱结构的LED。所谓薄膜倒装LED,就是将薄膜LED与倒装LED的概念结合起来。在将LED倒装在基板上后,采用激光剥离技术将蓝宝石衬底剥离掉,然后在暴露的n型GaN层上用光刻技术做表面粗化。如图4-7所示,这种薄膜结构的LED可以有效地增加出光效率。但相对来说,这种结构工艺比较复杂,成本会相对较高。
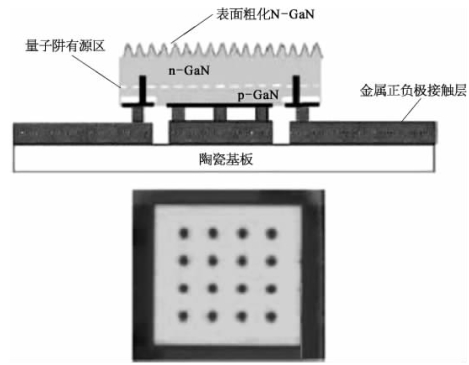
图4-7 薄膜倒装LED芯片结构示意图
(2)垂直芯片
倒装结构LED利用共晶焊技术将大尺寸LED芯片与导热基底焊接在一起,使得其在散热效果上有很大的改善,但是倒装结构LED仍然需要刻蚀出n区,减小了发光面积,且仍是横向结构,电流拥挤现象明显,限制了驱动电流的进一步提升。
垂直型GaN LED的截面图如图4-8所示。LED芯片的垂直设计是基于导电衬底,如硅、碳化硅、金属合金等。电流直接从顶部的n型接触直线流到底部的p型接触。
垂直型LED具有诸多优势。首先,垂直型LED将导电衬底作为下电极,器件上表面只有一个电极,增大了发光区域的面积。另外,垂直型LED具有更加均匀的电流密度分布,避免了水平型结构由于电流密度分布不均产生的局部过热,能够承载更高的正向电流,可增强LED在大功率和大电流方面的应用。此外,垂直型LED的结构更加简单,制备更加容易,并允许在保持性能不变的情况下灵活改变芯片的尺寸。
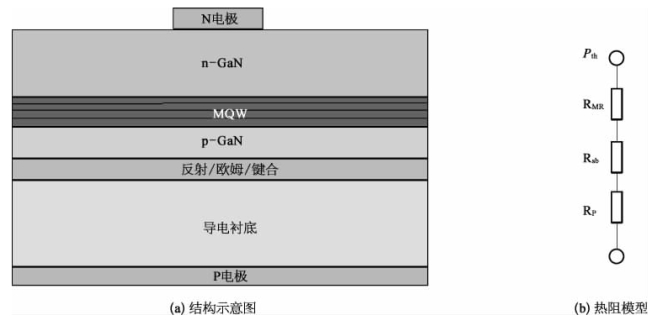
图4-8 垂直结构LED芯片示意图及热阻模型
根据垂直结构LED芯片的特点,可知发光层产生的热量流经p-GaN层、反射/欧姆/键合层、导电衬底、P电极层,到达外部连接部分,因此其热阻主要由反射/欧姆/键合层热阻RMR、导电衬底热阻Rsb、P电极热阻RP串联组成(见图4-8b)。
根据4.1.1节的分析,垂直结构GaN的热通道各环节的尺寸、热导率及热阻见表4-5。
表4-5 典型1W GaN基垂直芯片各层尺寸、热导率及热阻
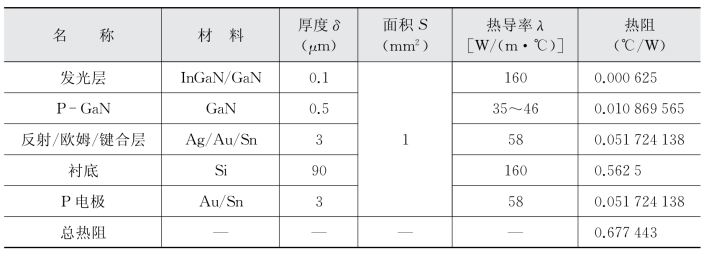
根据在制备过程中是否需要剥离衬底,GaN基垂直结构LED芯片可分为两类。一类是以或单晶GaN或导电SiC为衬底制备的垂直结构LED芯片。单晶GaN的生长技术还很不成熟,因此价格十分昂贵,暂不满足应用于市场的成本要求。SiC衬底具有高电导、热导,因此可以利用以其为衬底的GaN外延片制备的大功率垂直结构LED芯片,然而,SiC材料不易形成良好的欧姆接触,并且价格昂贵,目前主要以Cree为代表。另一类是衬底转移技术。GaN基垂直结构LED芯片的衬底转移分为两步:先将GaN外延层固定到第二衬底上,再移除蓝宝石第一衬底。第二衬底通常利用晶圆键合或电镀技术形成,而蓝宝石衬底的移除则通过激光剥离或化学湿法剥离技术实现。导电支持衬底(第二衬底)包括金属及合金衬底、硅衬底等。衬底转移技术有效地解决了芯片的散热和提高出光效率的问题[35]。
SiC衬底垂直结构的LED芯片(Cree)热阻估值为0.37℃/W,Cu衬底垂直结构的LED芯片(SemiLEDs)热阻估值为0.34℃/W。表4-5的计算热阻为0.68℃/W。可见垂直结构LED芯片热阻低于1℃/W,比正装和倒装结构LED芯片热阻要小很多。表4-6为商业化薄膜型大功率芯片技术。
表4-6 商业化薄膜型大功率芯片技术分析
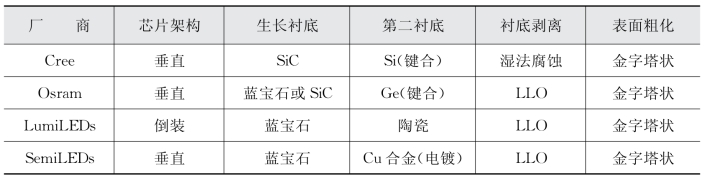
垂直结构的LED需要至少一根金线,从而与外界电源相连接,每根金线本身及其两个焊点是良品率和可靠性降低的原因之一,金线所占用的空间增大了垂直氮化镓基LED的封装产品的厚度。
5)三维垂直芯片
把无须打金线的垂直结构LED芯片统称为“三维垂直结构LED芯片”。一般通过“通孔”及“金属填充塞”将上端的N极连接到第二衬底形成第一电极,通过电镀等方面在第二衬底另一端形成第二电极(见图4-9),再通过回流焊或共晶焊将通孔垂直结构的LED芯片的第一电极和第二电极与封装管座或热沉或PCB板等焊接在一起(参考沈阳方大资料)。

图4-9 三维垂直结构LED芯片示意图及热阻模型
通孔垂直结构的LED产生的热量通过高热导率的反射/欧姆/键合层、金属层、支持衬底/通孔/金属填充塞、第一和第二电极传导出去。不难计算出,通孔垂直结构的LED芯片的热阻很小。在计算中,保护层为75μm×75μm,略去反射/欧姆/键合层中的银层的热阻,金属填充塞为铜并且占有硅支持衬底的60%的面积,因此其热阻主要由反射/欧姆/键合层热阻RMR、导电衬底热阻Rsb及通孔金属柱Rmc(二者并联)、电极热阻RP串联组成(见图4-9b),总热阻见表4-7。
表4-7 典型1W GaN基三维垂直结构各层尺寸、热导率及热阻

与垂直结构LED芯片相比,三维垂直结构LED芯片的主要优势在于无须打金线,使得其封装的厚度更薄、散热效果更好,并且更容易引入较大的驱动电流[36]。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。







