现在使用的IGBT的细节结构跟前面分析的IGBT基本机构比,有了很多变化。IGBT正是在逐代演变中成长、成熟,几个生产IGBT的大公司对IGBT的技术演化划分并不相同。在此仅是延用其中的一种说法来对IGBT结构上演变进行展示和比较。
近20年来,IGBT的发展很快,技术改进方案很多,并且实用化。每种改进措施的采取,都会把IGBT的性能向前推进。其中,最重要的还是不断把“通态压降-开关时间”的矛盾处理到更为优化的折中点,降低通态压降是双极型器件的电导调制特性的优势,提高开关速度是单极型MOS结构的优势。总体看,随着重大技术改进措施的成功,可以把IGBT的演变归纳成以下五代。
1.平面栅穿通型外延衬底IGBT
图4-44给出了平面栅穿通(PT)型外延衬底IGBT结构示意图,就是上面分析IGBT基本结构所用的结构图。这是最初的IGBT概念提出时的原型产品。它提出了在VDMOSFET结构中电导调制来降低通态压降的基本方案。这样在IG-BT的通态电流中出现了两个双极型和单极型两个分量。调整这两个分量所占的比例,成为处理上述折中的主要手段。这时的IGBT电压还比较低(600V左右),基区太薄(几十μm),只能采用尺寸较大外延衬底片。在其额定电流的70%左右,出现负电阻温度系数向正电阻温度系数的转变,所以与此相关的优缺点分析尚不显著;寄生晶闸管的擎住效应还不能在其全工作范围内得到有效抑制。即使这样,IGBT开始在中小容量电力电子变换器中向BJT提出了强劲的挑战,并取得越来越大的市场份额。这时,IGBT的通态压降在2.3~2.6V。
2.精密平面栅穿通(PT)型外延衬底IGBT
图4-45给出了精密平面栅穿通型外延衬底IGBT结构。在该结构的IGBT同时还采用了少子寿命控制技术。器件纵向尺寸更加优化,减薄有效基区厚度和硅片总厚度来减小通态压降,同时降低该发射结的注入系数,以抑制“晶闸管效应”。器件横向(平面)采用精密图形,减少每个元胞的尺寸,提高器件的开关速度。再采用专门的扩铂与快速退火措施,以控制基区内少数载流子寿命的较合理分布。这样的IGBT耐压达到1200V,通态压降达到2.1~2.3V,锁定效应得到有效抑制。这时,IGBT已经充分实用化了。
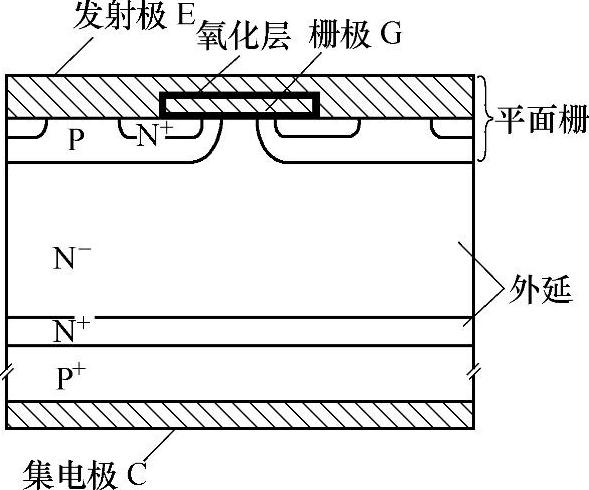
图4-44 平面栅穿通(PT) 型外延衬底
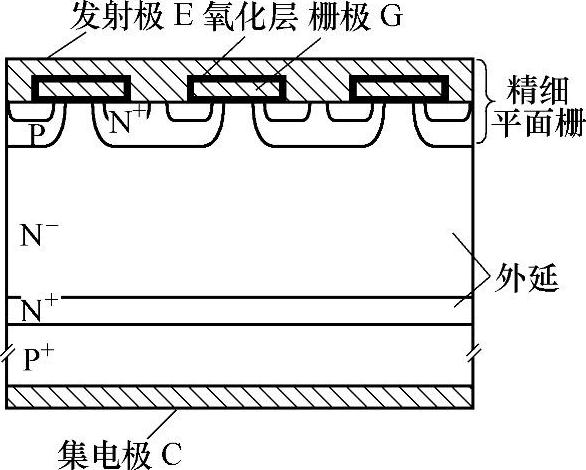
图4-45 精密平面栅穿 通型外延衬底
3.沟槽栅型IGBT
图4-46中给出了沟槽栅型IGBT结构图。这一代IGBT可以看作沟槽型VD-MOSFET与PN结电导调制效应的结合。沟槽栅的使用可以有效地降低器件中MOS电流产生的通态压降,可降低到1.7~2.0V。此时1700V的IGBT面市了,其工艺更加成熟,应用也更加广泛。
4.非穿通型IGBT
图4-46中给出了非穿通型IGBT结构图。随着阻断电压突破2000V的需求,IGBT中随承受电压的基区宽度超过150μm。这时靠高阻厚外延来生成硅衬底的做法,不仅十分昂贵(外延成本同外延层厚度成正比),而且外延层的掺杂浓度和外延层厚度的均匀性都难以保证。这时,采用区熔单晶硅片制造IGBT的呼声日渐成熟,成本可以大为降低,晶体完整性和均匀性得到充分满足。而非穿通结构的采用,使得IGBT几乎在全电流范围的工作区内都呈现正电阻温度系数的单极型器件的特点,这带来非常重要的好处。由几十个2500V/60A“小”芯片在封装时并联构成的2500V/1000A的IGBT压接式器件问世了。IGBT由此开始跨入了更大功率应用的门槛。此时,同规格器件的通态压降也达了1.5~1.8V的水平。
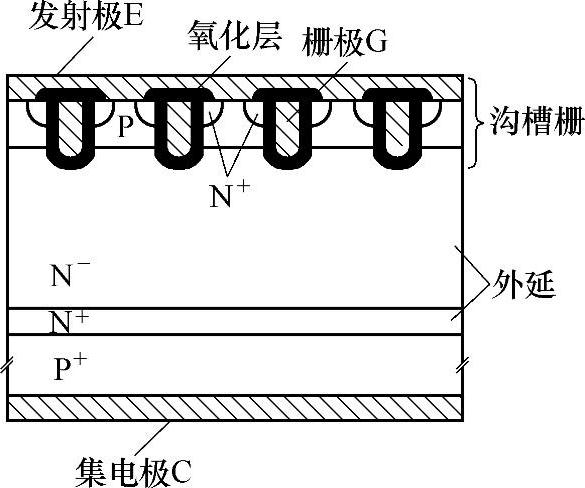 (https://www.daowen.com)
(https://www.daowen.com)
图4-46 沟槽栅型IGBT结构图
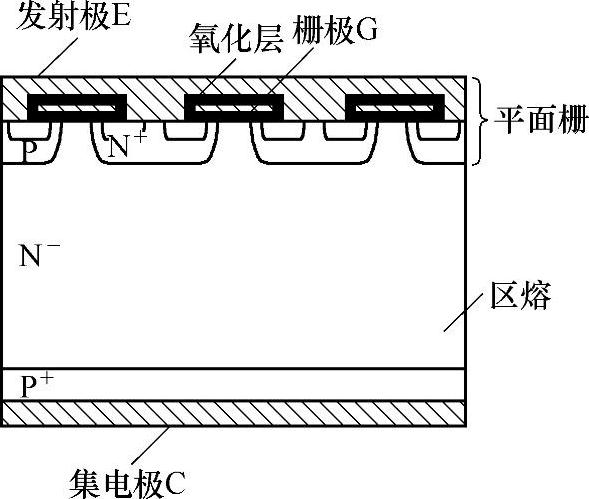
图4-47 非穿通型IGBT结构图
5.电场截止(FS)型IGBT
图4-48中给出了电场截止型IGBT结构图。当单管阻断电压进一步提高,硅片的基区厚度就会急剧增加。于是,IGBT的通态压降势必随其耐压的提高而增大。电场截止型IGBT吸收了PT型和NPT型两类器件的优点,形成硅片厚度比NPT型器件薄约1/3、又保持正电阻温度系数单极特征的各项优点。
电场截止型结构,设置的缓冲层掺杂浓度比PT结构的N+层低,但比基区N-层浓度高,此时基区可以明显减薄,却还能保留正电阻温度系数的特征。当然,这样的制造难度增大了。但是,此种结构的IGBT已经达到单管6500V的水平。采用电场截止结构的IGBT被称为弱穿通(LPT)IGBT。电场截止型结构是在IGBT的垂直方向的改进。而在IGBT的栅极上,通过引入插入式组合元胞(PCM)设计解决普通沟槽结构的缺点,也就是采取宽元胞间距结构来保持短路电流相对较小。除了采用沟槽栅结构和PCM结构之外,还采取在P基区和N-漂移层之间形成一个N型层,即所谓“载流子储存层”(CS层)的设计,使能够储存载流子。所以,CS层对于改善N-漂移区内的电导,从而减小IGBT的通态压降是很有用的。有此结构的IGBT又可以称为载流子储存的沟槽栅双极晶体管(CSTBT)。
这五代IGBT产品的特点的概括见表4-2。其中功率损耗为IGBT的总功率损耗,包括通态损耗、阻态损耗、开通损耗、关断损耗和栅驱动损耗之和。而性能指数是为了定量地比较各种IGBT的性能,引入了“性能指数(FOM)”的指标。

其中UCE(sat)是IGBT的通态饱和压降,单位V;tf是IGBT的关断时间,单位s。FOM高的器件表明其综合性比较好。
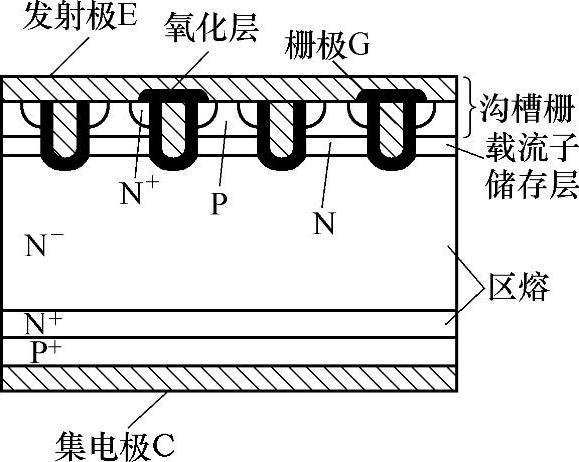
图4-48 电场截止和载 流子储存结构IGBT
表4-2 五代IGBT产品的特点比较(*:相对值)

总之,经过20多年的发展,随着材料、工艺技术的不断进步,单极型特性和双极型特性的优化平衡,IGBT已经成为高开关速度,大关断电流、高阻断电压的典型大功率电力半导体器件。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。







