垂直GaN基功率晶体管相对于横向结构发展较晚,目前仍处于起步阶段,主要包括垂直电流孔径晶体管(CAVETs)和金属-氧化物-半导体晶体管(MOSFETs)两种类型。
1.垂直电流孔径晶体管
为了避免横向AlGaN/GaN HEMT器件的电流崩塌效应,Ben-Yaacov等人于2004年首次提出了一种新型GaN基垂直电流孔径晶体管结构,综合利用HMET中天然的高浓度2DEG与垂直二极管结构的优势,将表面高电场转移至器件内部,获得了良好的器件性能。
CAVETs结构如图4.2.8所示,外延层从下到上依次为漏极欧姆接触层、轻掺杂的n--Ga N漂移层、电流通孔、p-Ga N电流阻挡层(Current blocking layer,CBL)和AlGaN势垒层。其中CBL层具有阻挡电子、限制电流通孔大小的作用。CAVETs电极结构与HEMT类似,也有栅、源、漏三个电极,有所不同的是,CAVETs的源、漏电极是垂直上下分布的,源极金属覆盖到AlGa N/Ga N界面的2DEG,漏电极在衬底一侧,栅电极在表面控制其下方的2DEG浓度。
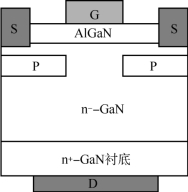
图4.2.8 GaN基CAVET结构示意图[32-33]
器件在开态状态下工作时,2DEG沟道打开,电子从器件顶部的源电极注入,沿着2DEG沟道到达电流通孔并进入漂移层,最后被漏电极收集。关断条件下,在栅极施加电压使其下方的2DEG被耗尽,从而阻断了源极注入电子向电流通孔输运的通道,漏源之间电流通道被截止。此时,轻掺杂的n--Ga N漂移层主要具有耐压的作用。与横向HEMT相比,CAVETs漏和源以及漏和栅之间的电场主要沿垂直方向分布,一方面避免了表面电子态可能引起的电流崩塌效应,另一方面方便通过调控轻掺杂Ga N层的厚度来控制击穿电压,无须增加器件的横向尺寸,适于集成化、小型化应用。
CAVETs结构中的CBL对于器件的性能至关重要,高质量的CBL的制作是提高CAVETs器件性能的关键技术之一。除了图4.2.8所示中用p-Ga N作为CBL层之外,早期人们也尝试过采用SiN、SiO2等绝缘材料、利用空气隙或者用Al离子、Mg离子注入的方法来制作CBL,但是导致的结果是,用绝缘层材料二次外延生长的外延质量有所下降,以致器件漏电流大,而用离子注入的方法可能也会造成晶格损伤产生缺陷,导致垂直方向的电流崩塌。Yeluri[32]等人用MOCVD直接生长Mg掺杂的p-GaN作为CBL,再用等离子体刻蚀的方法刻蚀出窄沟槽,在此基础上用MBE方法进行二次外延,得到器件的最大电场值达3.1 MV/cm,导通电阻为0.4 mΩ·cm2。
CAVET与横向HEMT器件类似,也有耗尽型(常开型)和增强型(常关型)之分。图4.2.8所示的是耗尽型器件,由于天然2DEG沟道的存在,当栅压为零时,漏源之间仍然导通,阈值电压为负值。为了实现增强型器件,人们在常规CAVETs器件的基础上又提出了一些改进结构。例如,图4.2.9(a)所示的是利用p型栅结构实现增强型CAVETs,原理与p型栅增强型HEMT相同,在栅电极与势垒层之间的p-GaN能够抬高2DEG界面处的能带,在栅压为零时耗尽其下方的2DEG,实现增强型器件。为了进一步增大阈值电压,Shibata[34]等人提出了图4.2.9(b)所示的器件结构,利用图示的V形结构获得半极性面。由于半极性面的极化强度较弱,V形侧壁半极性面AlGa N/Ga N界面2DEG浓度较低,更容易被耗尽,因此相比于图4.2.9(a),图4.2.9(b)所示的器件能够获得更高的阈值电压。基于此结构制作的器件,实现了击穿电压达1700 V,阈值电压达2.5 V的性能指标。
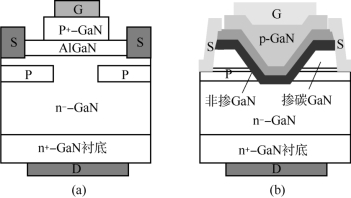 (www.daowen.com)
(www.daowen.com)
图4.2.9 极性面和半极性面p型栅CAVETs结构示意图[34]
2.垂直金属—氧化物—半导体晶体管(MOSFETs)
另一种垂直GaN基晶体管是垂直MOSFET结构,目前主要有凹槽形和垂直鳍式两种结构形式。
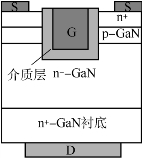
图4.2.10 GaN基垂直凹槽形MOSFET的结构示意图[33,35]
图4.2.10所示为垂直凹槽形MOSFET的结构示意图,由于此结构中没有AlGa N/GaN异质结,是一种常关型器件。当栅压为零时,漏电极和源电极之间是n-p-n结构,当对漏电极施加正偏压时,n--Ga N与p-Ga N形成的pn结呈反偏状态,阻挡了漏极和源极之间的电流通路。施加正向偏压至一定阈值,p-Ga N在与绝缘介质层界面处发生发型,在介质层侧面形成n型沟道,此时,绝缘层侧壁附近pn结被消除,在漏极电压下,漏源电流被导通,这就是垂直凹槽形MOSFET结构的工作原理。Oka[35]等利用此种结构实现了击穿电压为1200 V、阈值电压为3.5 V、导通电阻为1.8 mΩ·cm2的器件性能。
垂直凹槽形MOSFET的p-GaN层中电子迁移率比较低,而且源电极金属难以与p-GaN层形成良好的欧姆接触,造成漏源之间串联电阻大;而垂直鳍式MOSFET结构中无须p-GaN层,可以避免上述问题。鳍式MOSFET的结构如图4.2.11所示,在此结构中,鳍型n-Ga N沟道很窄,当栅压为零时,由于栅金属与n-Ga N之间的功函数差异,n-GaN沟道被耗尽,漏源之间的导电通道被阻断,器件呈关断状态。随着栅压的增大,耗尽区宽度逐渐减小,导电通道重新形成,器件呈导通状态。Sun Min[36]等人用此结构报道了击穿电压为800 V、阈值电压为1 V、导通电阻为0.36 mΩ·cm2的器件性能。
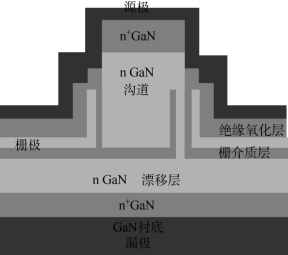
图4.2.11 GaN基垂直鳍型MOSFET结构示意图[33,36]
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。






