在研究中,设计了两种外延结构,结构Ⅰ是上面的普通传统的InAs/AlSb HEMT器件,如图3.4(a)所示,这个结构中包含单个δ面掺杂。AlSb下势垒层,InAs沟道层,AlSb上势垒层包含δ面掺杂,InAlAs肖特基势垒层和InAs帽层。结构Ⅱ是一种新的InAs/AlSbHEMT器件外延结构,如图3.4(b)所示。和传统的InAs/AlSbHEMT器件结构Ⅰ相比,区别是结构Ⅱ包含双δ面掺杂,器件包含两个势垒层和两个δ面掺杂层。第一个面掺杂在与沟道晶格匹配的AlSb下势垒层中插入,有10nm 的空间层。沟道设计和传统的结构Ⅰ是一样,接着在沟道上面形成多厚空间层和第二个δ面掺杂层。最后,设计了8nm 上势垒层,5nm 的InAlAs势垒层和5nmInAs帽层。图3.5是结构Ⅱ在热平衡时的能带图。
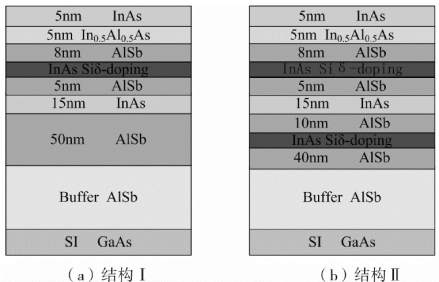
图3.4 InAs/AlSb HEMT 外延结构
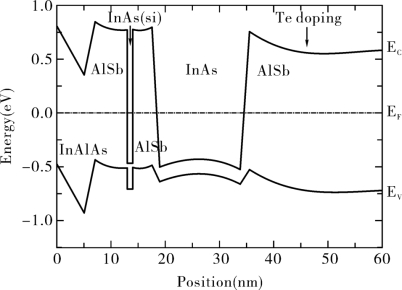
图3.5 InAs/AlSb HEMT 结构Ⅱ的能带图
图3.6是结构Ⅰ和结构Ⅱ仿真得到的InAs/AlSbHEMT 器件输出特性曲线。图中三角形标识的线代表结构Ⅰ单掺杂外延,正方形标识的线是结构Ⅱ代表双δ面外延,从图3.6中看到当VDS是0.6V,VGS是-0.4V时,结构Ⅱ对应的IDS是832mA/mm,而结构Ⅰ的IDS是576mA/mm,结构Ⅱ的饱和输出电流要比结构Ⅰ高,是由于结构Ⅱ是双δ掺杂,得到的二维电子气浓度大。结构Ⅰ当栅电压VG=-1.0V 时,VG漏源端电流ID 电流很小,认为器件处于关断状态。而对于结构Ⅱ的VG=-1.2V 时,漏源端电流ID电流很小,此时认为HEMT 器件关断,这也可以从图3.7的开关特性曲线中观察到。双δ面掺杂的结构Ⅱ的栅极电压绝对值要大一些,可能是由于结构Ⅱ由于是双δ掺杂,这样InAs沟道中2DEG 浓度大,所以HEMT 器件关断要用较大的栅极电压。同时还发现,栅电压变大时,输出特性曲线的饱和区域很小,而当栅极电压的值较小时,输出特性曲线的饱和区域较大。VDS >VGS-VP 是HEMT 器件饱和临界条件,当栅极电压VGS增大,达到电流饱和的临界VDS 值会相应变大。注意VP是器件夹断电压,对于同样的器件,夹断电压VP是不变的。言外之意,就是当栅极电压变大时,要更大的VDS才能达到饱和。图3.8显示新结构Ⅱ在VGS取-0.3 V,峰值跨导是1208 mS/mm,结构Ⅰ在VGS 取-0.27 V 时,峰值跨导是1047mS/mm,结构Ⅱ的跨导也要比结构Ⅰ要大。图3.9仿真器件的截止频率可以看到,新结构Ⅱ的器件截止频率在330GHz,而结构Ⅰ的截止频率在260GHz。从仿真结果可以看出新结构Ⅱ的InAs/AlSbHEMT 器件的直流和频率特性都比结构Ⅰ要好。
 (https://www.daowen.com)
(https://www.daowen.com)
图3.6 结构Ⅰ和结构Ⅱ的InAs/AlSb HEMT 的JDS-VDS 关系曲线

图3.7 结构Ⅰ和结构Ⅱ转移特性曲线

图3.8 结构Ⅰ和结构Ⅱ的HEMT 器件跨导

图3.9 结构Ⅰ和结构Ⅱ的 随频率的变化
随频率的变化
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。








