构建InAs/AlSb HEMT 器件结构如图3.2所示,在图中要仿真的是InAs/AlSb HEMT 器件的电学特性,半绝缘衬底和缓冲层对于器件的电学特性影响很小,在器件实际工作中,电流主要是通过沟道传输,所以器件工作中实际起作用的外延层是下面的AlSb势垒层及以上的各层异质材料,所以在仿真时为了减小计算量和提高仿真效率,只采用如图3.3所示的结构。在这个结构中去掉了缓冲层和半绝缘衬底,具体的各层材料作用在下面做了详细的阐述,InAs/AlSb HEMT 器件的外延材料列于表3.1。
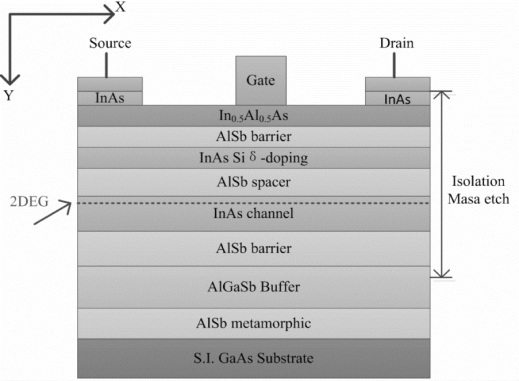
图3.2 InAs/AlSb HEMT 器件结构
表3.1 InAs/AlSb HEMT 外延结构
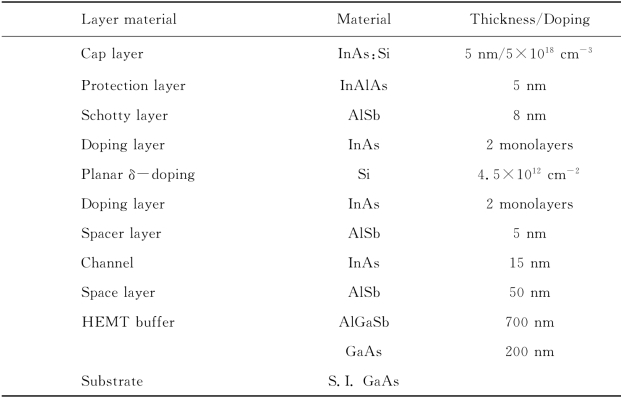
帽层(Cap layer):InAs材料在为HEMT器件的帽层材料,在InAs材料中采用重掺杂,为了得到低欧姆阻值的源漏端。同时,由于InAs材料是窄禁带宽度(Eg=0.3eV)材料,所以采用InAs材料作为HEMT器件的帽层材料可以得到很低的欧姆接触阻值。
阻挡层(Protection layer):InAlAs材料作为栅金属和半导体材料接触形成肖特基势垒层材料。AlSb材料很容易氧化,在AlSb上层势垒材料的上面采用InAlAs材料可以有效的阻值AlSb材料氧化。另外一个作用是InAlAs材料可以作为势垒阻挡层,由于InAs材料是窄禁带宽度材料,很容易发生碰撞离化产生电子空穴对,而InAs沟道中空穴容易越过AlSb上势垒层而进入到栅电极,使得栅极漏电流增大,在栅金属和AlSb上势垒层之间插入InAlAs材料,InAlAs材料导带底部比AlSb材料低,这样InAlAs材料可以有效阻值空穴进入到栅极,从而减小栅极漏电流。(www.daowen.com)
势垒层(Spacer layer):也称为隔离层,AlSb材料作为隔离层材料。AlSb材料禁带宽度1.6eV较大,和InAs材料形成异质结,这两种材料的导带带阶很大(ΔEc=1.35eV),比其他的Ⅲ-Ⅴ族材料都大,这样可以很好的限制InAs势阱中二维电子气。同时AlSb材料空间隔离层,可以把调制掺杂δ面掺杂的电离施主杂质和二维电子气在空间上分开,降低电离杂质散射对2DEG的影响,进而提高二维电子气浓度的电子迁移率。
沟道层(Channel layer):InAs材料作为HEMT器件的沟道材料。InAs材料在室温下电子迁移率可以达到30000cm2/Vs,电子速度是4×107cm/s,同时InAs材料的性能很稳定。InAs沟道材料和AlSb势垒层之间的导带带阶很大1.35eV,使得2DEG限制在平面势阱中运动。
下势垒层:AlSb材料作为沟道下势垒层材料,一方面是为了与InAs材料形成异质结,形成很深势阱,另一方面是由于InAs材料禁带宽度窄,晶格常数大,与半绝缘衬底材料GaAs,InP和Si材料失配,使用AlSb材料作为沟道下势垒材料和InAs材料晶格匹配,同时减弱沟道材料和衬底材料的失配影响。
调制δ面掺杂:在AlSb上势垒层中加入薄InAs量子阱中进行Si的δ面掺杂。
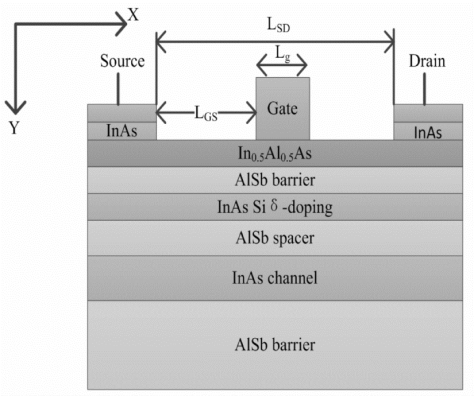
图3.3 器件ISE仿真结构
图3.3构建的仿真器件,源漏间距1.8μm,栅长是350nm。器件仿真中,为了让仿真器件更接近实际制作的器件,在器件模型中加入了等效电阻Rs和RD。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。






