扩散技术出现于20世纪50年代,长期以来在晶体管和集成电路生产中得到广泛的应用。“扩散”是一种基本的掺杂技术。通过扩散可将一定种类和数量的杂质掺入硅片或其他晶体中,以改变其电学性质,扩散技术的原理是利用物质在热运动下,会从浓度高的向浓度低的地方运动,并最终使其分布趋于稳定。
在硅中掺入少量Ⅲ族元素可获得P型半导体,掺入少量Ⅴ族元素可获得N型半导体。掺杂的浓度范围为1014~21个/cm3,而硅的原子密度是5×1022个/cm3,所以掺杂浓度为1017个/cm3时,相当于在硅中仅掺入了百万分之几的杂质,如表6.1所示。
表6.1 掺杂浓度

扩散法是将掺杂气体导入放有硅片的高温炉,并将杂质扩散到硅片内一种方法。优点是可以批量生产,获得高浓度掺杂。扩散工艺定义:在一定温度下杂质原子具有一定能量,能够克服阻力进入半导体并在其中做缓慢的迁移运动。
1.杂质扩散的工序
杂质扩散有两道工序:预扩散(又称预淀积,Predeposition)和主扩散(drivein)。
预扩散工序是在硅表面较浅的区域中形成杂质的扩散分布,这种扩散分布中,硅表面杂质浓度的大小是由杂质固溶度来决定的。这一步采用恒定表面源扩散的方式,在硅片表面淀积一定数量Q的杂质原子。由于扩散温度较低,扩散时间较短,杂质原子在硅片表面的扩散深度极浅,如同淀积在表面,故通常称为预淀积。
主扩散工序是将预扩散时形成的扩散分布进一步向深层推进的热处理工序,其是通过固态扩散向半导体内引入施主或受主杂质,把经预淀积的硅片放入另一扩散炉内加热,使杂质向硅片内部扩散,重新分布,达到所要求的表面浓度和扩散深度。所以,这一步是有限表面源扩散,又常称为“再分布”。这种方法需要将硅置于适当杂质的蒸汽中加热,其温度要在900 °C以上。由于固态扩散技术非常简单,使得这种方法在半导体掺杂上较为盛行。在设备方面,所需要的仅仅是一个能将半导体晶体温度升至900 °C以上的炉子。但是,这种方法必须要采用氧化掩膜技术,以保证杂质仅仅引入到根据设计所选定的某些晶片的区域中。
2.常用的扩散方法分类
常用的扩散方法按其扩散的不同可分为:液态源扩散、片状源扩散、固-固扩散和双温区锑扩散。
(1)液态源扩散:主要是使保护气体通过含有扩散杂质的液态源,从而携带杂质蒸气进入处于高温下的扩散炉中。杂质蒸气在高温下分解,形成饱和蒸气压,原子通过硅片的表面向内部扩散。其特点主要是设备简单、操作方便、均匀性好,适于批量生产。
(2)片状源扩散:扩散源为片状固体扩散源,外形与硅圆片相同,扩散时将其与硅片间隔放置,并一起放入高温扩散炉中。
(3)固-固扩散:在硅片表面用化学汽相淀积等方法生长薄膜的过程中同时在膜内掺入一定的杂质,然后以这些杂质为扩散源在高温下向硅片内部扩散。薄膜可以是掺杂的氧化物、多晶硅、氮化物等。目前,以掺杂氧化物最为成熟,其在集成电路生产中得到广泛的应用。
(4)双温区锑扩散:其在加工时,扩散炉分两个区域,一个为低温区(一般为950 °C),用来放置掺杂源Sb2O3以控制杂质蒸汽压;另一个为放置硅片的高温区(一般为1 250 °C),扩散时,利用保护气体通过低温区携带Sb2O3蒸气进入高温区,从而完成扩散过程。
以上四种扩散方法都可以通过控制扩散温度、扩散时间以及气体流量实现对掺入杂质量的控制,扩散技术在结深为1 μm以上的半导体器件的生产中得到广泛的应用。
3.简要热扩散理论
对于热扩散技术来说,往往都需要较高的扩散温度;因为施主或受主杂质原子的半径一般都比较大,要它们直接进入到半导体晶格中去是很困难的,然而如果利用高温产生出一些热缺陷,则通过这些热缺陷的帮助即可容易地扩散并进入到半导体中去。
Fick定律和杂质浓度分布:
粒子依靠浓度梯度的扩散运动,是在混乱热运动基础之上的一种定向运动(从高浓度处往低浓度处扩散)。其扩散流密度j与浓度梯度dN/dx成正比——Fick第一定律(一维情况):(https://www.daowen.com)

由于扩散流密度不是可直接测量的物理量,故Fick第一定律的使用是不便的。于是在此基础之上,再考虑到连续性方程,即引伸出其中变量较容易测量的Fick第二定律(一维情况,扩散系数D为常数):

求解Fick第二定律,即可得到粒子浓度随坐标的分布和时间的变化。
式中,D为扩散系数(cm2/s)。注意:扩散流与粒子的浓度梯度成正比,而与浓度N的绝对数量无关。
施主或者受主杂质原子通过热扩散而进入到半导体中之后,必须要处于替代晶格的位置才能起到提供载流子的作用,即具有电活性。从机理上来说,代位杂质原子扩散的具体方式主要有三种:
1)利用晶格空位的扩散
在杂质原子的代位式扩散机理中,可以有两种重要的扩散方式,如图6.19所示,即(a)直接交换方式和(b)空位交换方式。显然,在这两种代位扩散方式中,杂质原子利用空位的交换方式是最容易进行的(所需要的激活能较低),因此可以认为杂质原子的扩散等效于晶格空位的扩散。虽然杂质原子以代位方式扩散的速度较慢,需要的扩散温度较高(800~1 200 °C),但是这种扩散可以精确地控制扩散深度(P-N结的结深)和掺杂浓度,只要精确地控制扩散温度即可(往往要求温度控制精度达到±1 °C)。Si中硼、磷等杂质的扩散就属于代位式扩散。

图6.19 杂质原子代位式扩散的两种方式
2)利用自间隙原子的扩散
杂质原子也可以通过晶体的自间隙原子来进行扩散,即自间隙原子取代杂质原子,并把杂质原子推到替代晶格的位置上去,如图6.20所示。这种间隙式扩散只有在存在空位扩散时才会发生。实际上,Si中硼、磷的扩散就是利用Si自间隙原子和晶格空位这两种扩散机理来进行的。
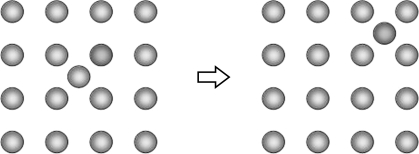
图6.20 杂质原子通过自间隙原子的扩散方式
3)通过晶格间隙的扩散
如图6.21所示,可以通过两种方式来让杂质原子进入到晶格位置,即挤出方式(杂质原子取代晶格Si原子)和Frank-Turnbull方式。Frank-Turnbull方式也称为代位—间隙方式(Si),即间隙杂质原子被空位俘获。这里不需要Si自间隙原子的帮助,而且这种间隙杂质原子具有溶解度低于替位原子的特点。此外,对于非施主和非受主杂质的扩散,情况将有所不同。如Au、Pt等重金属杂质,因为这些杂质原子的半径一般都较小,则这些原子可以直接在晶格间隙中穿行,因此它们的扩散速度都很快(在1 000 °C下10 min就可扩散200~300 μm的深度),则所需要的扩散温度也就较低一些(800~1 050 °C)。

图6.21 杂质原子通过间隙的扩散方式
总之,半导体中施主或者受主杂质原子的热扩散,主要是以代位式或者间隙式进行,扩散的速度较慢,所得到的浓度分布是不均匀的(erfc分布或Gauss分布),而且表面处的浓度高,体内的浓度低。但是半导体中一些半径较小的重金属杂质原子(Au、Cu、Pt等)的扩散多为简单的间隙式扩散,扩散速度很快,并因此可认为扩散以后的浓度分布基本上是均匀的(其浓度大小由该温度下的固溶度来决定)。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。







