1.光的反射(Reflection)
光射到任何表面的时候都会发生反射,并且符合反射定律:入射角等于反射角。在曝光的时候,光刻胶往往会在硅片表面或者金属层发生反射,使不希望被曝光的光刻胶被曝光,从而造成图形复制的偏差。常常需要用抗反射涂层(Anti-Reflective Coating,ARC)来改善因反射造成的缺陷。
2.光的折射(Refraction)
光通过一种透明介质进入到另一种透明介质的时候,会发生方向的改变,主要是因为在两种介质中光的传播速度不同。从直观来说是两种介质中光的入射角发生改变,所以我们在90 nm工艺中利用高折射率的水为介质(空气的折射率为1.0,而水的折射率为1.47),采用浸入式光刻技术,从而提高了分辨率,而且这种技术有可能将被沿用至45 nm工艺节点。光的折反射和透射如图5.1所示。

图5.1 光的折反射和透射
3.光的衍射(Diffraction)
光在传播过程中遇到障碍物(小孔或者轮廓分明的边缘)时,会发生光传播路线的改变。曝光的时候,掩膜板上有尺寸很小的图形而且间距很窄。衍射会使光部分发散,导致光刻胶上不需要曝光的区域被曝光。衍射现象会造成分辨率的下降。光的单缝衍射如图5.2所示。

图5.2 光的单缝衍射
4.光的干涉(interference)
波的本质是正弦曲线。任何形式的正弦波只要具有相同的频率就能相互干涉,即相长相消:相位相同,彼此相长;相位不同,彼此相消。在曝光的过程中,反射光与折射光往往会发生干涉,从而降低了图形特征复制的分辨率。
入射光和反射光发生干涉并引起光刻胶在厚度方向上的不均匀曝光,这种现象称为驻波效应,如图5.3所示。驻波效应降低了光刻胶成像的分辨率。深紫外光刻胶由于反射严重,驻波效应也严重。
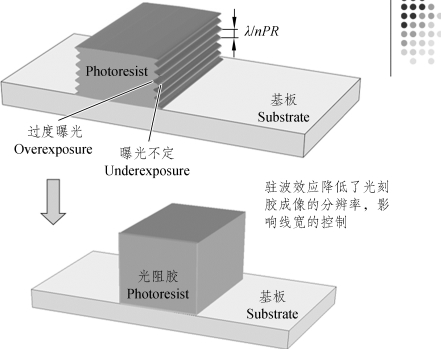
图5.3 光刻的驻波效应
5.调制传输函数(Modulation Transfer Function,MTF)
该函数用于定义明暗对比度的参数。即分辨掩膜板上明暗图形的能力,与光线的衍射效应密切相关。MTF=(Imax-Imin)/(Imax+Imin),好的调制传输函数,就会得到更加陡直的光刻胶显影图形,即有高的分辨率。临界调制传输函数(Critical Modulation Transfer Function,CMTF)主要表征光刻胶本身曝光对比度的参数,即光刻胶分辨透射光线明暗的能力。一般来说,光路系统的调制传输函数必须大于光刻胶的临界调制传输函数,即MTF>CMTF。
6.数值孔径(Numerical Aperture,NA)
透镜能够把一些衍射光会聚到一点成像,把透镜收集衍射光的能力指标用透镜的数值孔径表示,即透镜收集衍射光(聚光)的能力,如图5.4所示。
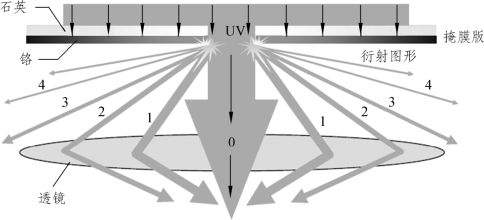
图5.4 数值孔径(NA)

式中,n为图像介质的折射率,θm为主光轴和透镜边缘线夹角。透镜半径越大,数值孔径越大成像效果越好。一般来说,NA大小为0.5~0.85。提高数值孔径的方法:(1)提高介质折射率 n,采用水代替空气;(2)增大透镜的半径。数值孔径在成像中的作用如图5.5所示。
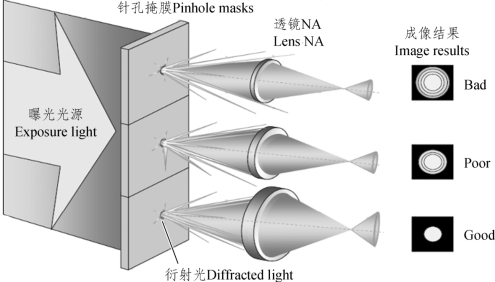
图5.5 数值孔径与成像
7.分辨率(Resolution)
分辨率指将硅片上两个相邻的关键尺寸图形区分开的能力。
![]()
式中,k为工艺因子,范围是0.6~0.8,λ为光源的波长,NA为曝光系统的数值孔径,要提高曝光系统的分辨率即减小关键尺寸,就要降低光源的波长λ。
提高分辨率的方法:(1)减小光源的波长;(2)采用高分辨率的光刻胶;(3)增大透镜半径;(4)采用高折射率的介质,即采用浸入式光刻技术;(5)优化光学棱镜系统以提高k(0.4~0.7)值(k是标志工艺水平的参数)。
分辨率比较如图5.6所示。

图5.6 分辨率比较
8.焦深(Depth Of Focus,DOF)
焦深是焦点上下的一个范围,在这个范围内图像将连续保持清晰。焦深也就是景深,集成电路光刻中的景深很小,一般在1.0 μm左右或更小。焦深表示焦点周围的范围,在该范围内图像连续地保持清晰。焦深如图5.7所示。
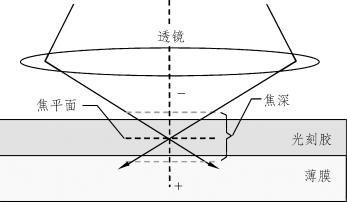
图5.7 焦深(www.daowen.com)
焦深是焦点上面和下面的范围,焦深应该穿越整个光刻胶层的上下表面,这样才能够保证光刻胶完全曝光。

增大焦深的方法:(1)增大光源的波长;(2)采用小的数值孔径;(3)利用CMP进行表面平坦化。由于前两种方法会降低分辨率,而分辨率是芯片制造所努力提升的重要参数,因此我们需要在看上去相互矛盾的两个方面做出某种平衡。一般在保证基本的焦深要求下不降低分辨率,即以分辨率为主。所以,现在一般采用CMP平坦化技术保证足够的焦深。DOF和NA关系如图5.8所示。
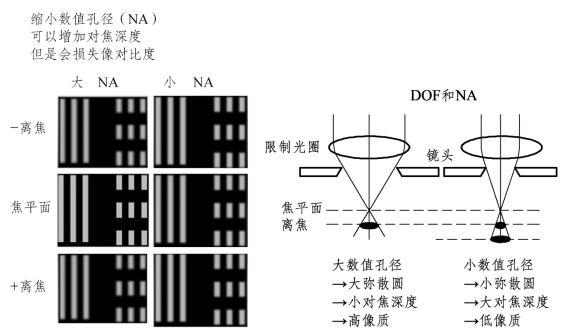
图5.8 DOF和NA关系
9.光刻中常见的效应和概念
1)驻波效应(Standing Wave Effect)
现象:在光刻胶曝光的过程中,透射光与反射光(在基底或者表面)之间会发生干涉,这种相同频率的光波之间的干涉,在光刻胶的曝光区域内出现相长相消的条纹,光刻胶在显影后,在侧壁会产生波浪状的不平整问题。
解决方案:
(1)在光刻胶内加入染色剂,降低干涉现象。
(2)在光刻胶的上下表面增加抗反射涂层。
(3)后烘(Post Exposure Baking,PEB)和硬烘(Hard Baking,HB)。
2)摆线效应(Swing Curve Effect)
现象:在光刻胶曝光时,以相同的曝光剂量对不同厚度的光刻胶曝光,从而引起关键尺寸(Critical dimension,CD)的误差。
3)反射切口效应(Notching Effect)
现象:在光刻胶曝光时,由于接触孔尺寸的偏移等原因使入射光线直接照射到金属或多晶硅上发生反射,使不希望曝光的光刻胶被曝光,显影后,在光刻胶的底部出现缺口。
解决方案:① 提高套刻精度,防止接触孔打偏;② 涂覆抗反射涂层。
4)脚状图形(Footing Profiles)
现象:在光刻胶的底部,出现曝光不足。使显影后,底部有明显的光刻胶残留。
解决方案:① 妥善保管光刻胶,不要让其存放于碱性环境中;② 在涂覆光刻胶之前,硅片表面要清洗干净,防止硅基底上有碱性物质的残余。
5)T型图形(T-Top Profiles)
现象:由于表面的感光剂不足而造成表层光刻胶的图形尺寸变窄。
解决方案:注意腔室中保持清洁,排除腔室中的碱性气体污染。
6)分辨率增强技术(Resolution Enhanced Technology,RET)
包括偏轴曝光(Off Axis Illumination,OAI)、相移掩膜板技术(Phase Shift Mask,PSM)、光学近似修正(Optical Proximity Correction,OPC)以及光刻胶技术等。
(1)偏轴曝光:改变光源入射光方向,使之与掩膜板保持一定角度,可以改善光强分布的均匀性。但同时光强有所削弱。
(2)相移掩膜板技术(Phase Shift Mask,PSM):在掩膜板上,周期性地在相邻的图形中,每隔一个图形特征对掩膜板的结构(减薄或者加厚)进行改变,使相邻图形的相位相差180°,从而可以达到提升分辨率的目的。相移掩膜板技术使掩膜板的制作难度和成本大幅增加。
(3)光学近似修正(Optical Proximity Correction,OPC):在曝光过程中,往往会因为光学临近效应使最后的图形质量下降:线宽的变化、转角的圆化、线长的缩短等,需要采用智能型掩膜板工程(Clever Mask Engineering)来补偿这种尺寸变化。
7)显影后检测(After Development Inspection,ADI)
该检测主要是检查硅片表面的缺陷。通常将一个无缺陷的标准图形存于计算机中,然后用每个芯片的图形与标准相比较,出现多少不同的点,就会在硅片的defect map(缺陷图)中显示多少个缺陷。
8)抗反射涂层(Anti-Reflective Coating,ARC)
光刻胶照射到光刻胶上时,使光刻胶曝光,但同时,在光刻胶层的上下表面也会产生反射而产生切口效应和驻波效应。
① 底部抗反射涂层(Bottom Anti-Reflective Coating,BARC):将抗反射涂层涂覆在光刻胶的底部来减少底部光的反射。有两种涂层材料:有机抗反射涂层(Organic),在硅片表面旋涂,依靠有机层直接接收掉入射光线;无机抗反射涂层(Inorganic),在硅片表面利用等离子增强化学气相沉积PECVD形成。一般材料为:TiN或SiN。通过特定波长相位相消而起作用,最重要的参数有材料折射率、薄膜厚度等。
② 顶部抗反射涂层(Top Anti-Reflective Coating,TARC):不会吸收光,通过光线之间相位相消来消除反射,为一层透明的薄膜。
任务一学习成果评价
以团队小组为单位完成任务,以学生个人为单位实行考核。

免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。







